��±PCB�������������ܷ���չ
��±PCB�������������ܷ���չ
����ժ Ҫ�����ʴ������ᡢƻ�������ա��������Ⱥ��ƶ�����±ת��ʱ������������ٵ��Ӳ�Ʒ����±�����̡������������г�Ӧ���뻷�������������£���±PCB ������ϵ�ʹ������Ѹ�������ѷ�չ������ḻ�Ķ�����ϵ�в�Ʒ�������ߵ��ȵ���±PCB ������ϣ���������ϵ���ͣ��ߵ���ģ��/�߸��Ե���±PCB ������ϣ��ʹ�����ʧ����±PCB ������ϣ���Ҫ��Ը���PCB �ļӹ���ΪĿ�ĵ���±PCB ������ϣ���±������ȼ����±PCB ������ϣ����߸��ݻ�����ϵ������ص�Ը���˾���о���������±PCB ������Ͻ������ۺϷ�����
�����ء������ʣ���±��PCB ������ϣ����ȣ����ȣ��ʹ�����ʧ���ӹ��ԣ���±���ף��о���������
����1 ǰ��
������±��������±PCB ��������Ĺ��ԣ���������Ҫ����ͻ���������Ǹ���±PCB ������ϲ�Ʒ�����ԣ���������صĹ�ͬ�ƶ��£�ʱ�����գ��ѷ�չ������ḻ�Ķ�����ϵ�в�Ʒ[1-3] ���ȷ�˵������±�ߵ��ȵ�PCB ������ϣ���±��������ϵ���ͣ��ߵ���ģ��/�߸��Ե�PCB ������ϣ���±�ʹ�����ʧ��PCB ������ϣ���Ҫ��Ը���PCB �ļӹ���ΪĿ�ĵ���±PCB ������ϣ���±������ȼ��PCB ������ϣ��ȴ������Ľ���ǰ��������Ҫ����±PCB ������ϰ��������ص���з��࣬����Ҫ���ܸô�����Ʒ�����ԣ�����1����
| ��Ҫ���ص������ص� | Ŀ�� | ������Ʒ���ͺŻ��о��ṹ | |
| ��± | �ߵ��� | ɢ�� | ̨�幤��Ժ |
| ��������ϵ���ߵ���ģ���߸��� | ������Ǧ���ϣ� ͻ����ѧ���ܡ� | DS-7409HG ϵ��CS-3356S ����R-1515B | |
| PCB ������� | �ͽ�糣���͵ͽ�����Ľ����У� ��ƵӦ�ã� | ���ʹ�����ʧ | ̨��̨ҫ�Ƽ�CS-4387S MCL-LZ-71G MCL-HE-679G |
| ����PCB �ļӹ��� | ��ԭ���ļӹ����� | NPGN-150 | |
| ��±������ȼ | �Ի�������Ⱦ | DS-7409HG ϵ��̨������ |
��1 ��ͬ��±PCB������ϵ������ص�
��Ҫ���ص������ص� Ŀ�� ������Ʒ���ͺŻ��о��ṹ
��± �ߵ��� ɢ�� ̨�幤��Ժ
��������ϵ���ߵ���ģ���߸��� ������Ǧ���ϣ� ͻ����ѧ���ܡ� DS-7409HG ϵ��CS-3356S ����R-1515B
PCB ������� �ͽ�糣���͵ͽ�����Ľ����У� ��ƵӦ�ã� ���ʹ�����ʧ ̨��̨ҫ�Ƽ�CS-4387S MCL-LZ-71G MCL-HE-679G
����PCB �ļӹ��� ��ԭ���ļӹ����� NPGN-150
��±������ȼ �Ի�������Ⱦ DS-7409HG ϵ��̨������
����2 ���ܷḻ����±PCB�������
����2.1 �ߵ�����±PCB �������
����̨�幤��Ժ������1973 �꣬����Ժ������̨�����IJ�ҵ�����з����������ǿ���̨��뵼���ҵ���ȷ棬����̨��IJ�ҵ��չ���̾��о������صĵ�λ����2008 ��10 �£�Tzong-MingLee �ȱ�������±���ߵ��ȸ�ͭ������췽�������ܡ�
����2.1.1 ����
����(a) BMI ��֬��
����(b) ���Լ�����Ӧ��PI ���������õ������Ժ͵��ԣ�
����(c) ���ϣ��������ͣ���Al2O3��SiC ��AlN �ȣ�
����(d) �ܼ���DMF �����ױ��ȡ�
����2.1.2 �Ʊ�
������BMI ��֬����Ӧ��PI ���Լ������ϡ��ܼ�����佺������ճ��300~500cps/30 �棬��7628 ��������ǿ����210��/3h ������ѹ�Ƴ��͡�
������Ӧ��PI ����BMI ��֬��FT-IR ����ͼ1����3400~3500 cm-1 ���������մ�������(-NH) ����3097~3106 cm-1 �����մ���–C=C-����Ӧ����3400~3500 cm-1 ��3097~3106 cm-1 ��İ�����–C=C����ǿ�ȼ��٣�������Ӧ�������ߵ��ȸ�ͭ������ȶ����ܼ�ͼ2��

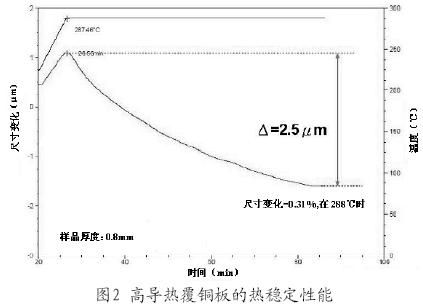
����2.1.3 ̨�幤��Ժ�ߵ�����±/����ͭ��һ������
�������ŵ��Ӳ�Ʒ�Ļ��������ͽ�����ʶ�����ӣ����нϺõ������Ժ�ɢ���Ե���±����ͭ���������г���ռһ����λ�����µķ�Ӧ��PI �������BMI ��֬�ĸ��Լ���ʹ�þ������ԡ����ȶ��ԣ�����±������ȼ�����¸�ͭ��ﵽUL-94V0 ����Tg(Tg> 230��)�����õ���ѧ�������ܣ��봫ͳFR-4 �ӹ��������ݣ��ɱ����ڴ�ͳBMI ���ϣ�ͬʱ������������ʹ���иߵ����ԣ�����HotDisk����ϵ�������Dz�������±����ͭ��ĵ���ϵ��ԼΪ1.3~1.5W/mK ���ߵ�����±/����ͭ������ܼ���2��
��2 �ߵ��ȸ�ͭ���һ������
| ��Ŀ | ��λ | ���� | ���� |
| Tg | �� | 230 | TMA |
| ������ϵ�� | ppm/�� | 20-25 | TMA |
| ��ˮ�� | % | 0.35 | PCT/30min |
| ��ȼ | - | V0 | UL 94 |
| ����ϵ�� | W/mK | 1.3-1.5 | Hot Disk? |
����2.2 ��������ϵ�����߸��ԡ��ߵ���ģ������±PCB �������
����2.2.1 ��ɽ����DS-7409HG(S) ��DS-7409HG��L��
�����������������ʵĹ��ԣ���ͬ���ʵ�������ϵ����CTE ���Dz�ͬ�ġ�ӡ����·������֬+�������ϣ��粣�ˣ�+ͭ���ĸ����ӡ����·��Ľ������ױں�ͭ����Z ���CTE ���ܴ������Ȳ��ܼ�ʱ�ų�����������ʹ���������ѡ��Ͽ��������豸�Ŀɿ��ԡ��Է�װ������ԣ���CTE ���ߵ���ģ��/�߸��ԡ����������Ѿ���ΪԽ��Խ��Ҫ�����ܣ������ǵ�CTE ���Կɿ��Ե�Ӱ����������ͼ3����
| 2007 | 2008 | 2009 | 2010 | 2011 | 2012 | 2013 | 2014 | |
| CTE��X,Y ����(ppm/��) | ||||||||
| ���Խṹ | 12 | 10 | 10 | 8 | 8 | 8 | 8 | 8 |
| ���㣨����ǿ���ϣ� | 12 | 10 | 10 | 10 | 10 | 10 | 10 | 10 |
| ���㣨����ǿ���ϣ� | 40 | 20 | 20 | 20 | 20 | 10 | 10 | 10 |
| ��״�ṹ | 20 | 16 | 16 | 16 | 16 | 16 | 16 | 16 |
| �մɽṹ | 3-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 |
| CTE��Z ����(ppm/��) | ||||||||
| ���Խṹ | 30 | 25 | 25 | 25 | 25 | 20 | 20 | 20 |
| ���㣨����ǿ���ϣ� | 30 | 20 | 20 | 20 | 20 | 20 | 20 | 20 |
| ���㣨����ǿ���ϣ� | 40 | 20 | 20 | 20 | 10 | 10 | 10 | 10 |
| ��״�ṹ | 20 | 20 | 20 | 20 | 20 | 20 | 20 | 20 |
| �մɽṹ | 3-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 |
�����������µ�2007ITRS ��װ����·��ͼ����װ����CTE �Ľ���Ŀ�����3����װ�����CTE �������ϸ�
��3 ��װ����CTE �Ľ���Ŀ��
| 2007 | 2008 | 2009 | 2010 | 2011 | 2012 | 2013 | 2014 | |
| CTE��X,Y ����(ppm/��) | ||||||||
| ���Խṹ | 12 | 10 | 10 | 8 | 8 | 8 | 8 | 8 |
| ���㣨����ǿ���ϣ� | 12 | 10 | 10 | 10 | 10 | 10 | 10 | 10 |
| ���㣨����ǿ���ϣ� | 40 | 20 | 20 | 20 | 20 | 10 | 10 | 10 |
| ��״�ṹ | 20 | 16 | 16 | 16 | 16 | 16 | 16 | 16 |
| �մɽṹ | 3-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 |
| CTE��Z ����(ppm/��) | ||||||||
| ���Խṹ | 30 | 25 | 25 | 25 | 25 | 20 | 20 | 20 |
| ���㣨����ǿ���ϣ� | 30 | 20 | 20 | 20 | 20 | 20 | 20 | 20 |
| ���㣨����ǿ���ϣ� | 40 | 20 | 20 | 20 | 10 | 10 | 10 | 10 |
| ��״�ṹ | 20 | 20 | 20 | 20 | 20 | 20 | 20 | 20 |
| �մɽṹ | 3-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 | 4-12 |
������ɽ����DS-7409HG(S) ���ص�����±���ס���CTE �����������¸ߵ���ģ������������(T-288 ����100min) ��Tg ����270�棨DMA ������DS-7409HG(S) ��ͻ���ص��ǵ�CTE �߸��ԣ�stiffness ����ͼ4 Ϊ���Բ���������ͼ5 Ϊ���ԱȽϣ�ͼ6 Ϊ����ʱ��ͭ�������ģ���Ƚϣ����Ϻ�������ͳ��DS-7409H< ͨ����-G ��<��CTE-S �͡���ɽ����DS-7409HG��L������CTE ��ҪӦ����FC-CSP ��SiP ��PoP �ȣ�ͼ7 ΪDS-7409HG��L����CTE �Ƚϡ�


